产品名称:反射光谱法测量半导体硅光致抗蚀剂膜厚15nm至50um
产品型号:SUP-TFMS-LD
产品描述:SUP-TFMS-LD反射光谱测厚仪是一种利用反射光谱测量薄膜厚度的仪器。它可以快速准确地测量透明或半透明薄膜的厚度,而不会损坏样品的表面,使其成为一种非破坏性的厚度计。
薄膜厚度的测量范围为15nm至50µm,提供了很宽的范围,特别适合测量超薄薄膜厚度。
产品描述
SUP-TFMS-LD反射光谱测厚仪是一种利用反射光谱测量薄膜厚度的仪器。它可以快速准确地测量透明或半透明薄膜的厚度,而不会损坏样品的表面,使其成为一种非破坏性的厚度计。
薄膜厚度的测量范围为15nm至50µm,提供了很宽的范围,特别适合测量超薄薄膜厚度。
测试仪器发出的光的波长范围为400nm至1100nm。这种宽波长范围允许膜厚度的宽测量范围。SUP-TFMS-LD反射光谱测厚仪测试系统的理论基础是镜面光纤反射探头。该仪器结构紧凑,节省了实验室空间,易于操作,读数直观,便于在实验室中放置和使用。
产品特征
1.测量和数据分析可以同时进行。它可以测量单层薄膜、多层薄膜、非基材薄膜和非均匀薄膜。
2.它包括500多种材料的光学常数,可以很容易地添加新材料的参数。它支持多种算法:柯西、陶克-洛伦兹、科迪-洛伦兹、EMA等。
3.仪器结构紧凑,便于放置和操作。
4.它可以测量薄膜厚度、材料光学常数和表面粗糙度。
5.操作通过计算机界面完成,只需点击一下即可进行测量和分析。
产品参数
| 产品名称 | 半导体硅光致抗蚀剂反射光谱膜厚测量 |
| 型号 | SUP-TFMS-LD |
厚度范围 | 非金属半透明材料为10 nm-150 um 注:金属薄膜只能可靠地测量到50 nm以下;较厚的胶片需要X射线测量 |
测量厚度 透明或 半透明薄膜 | 氧化物(示例见图1) 氮化物 光致抗蚀剂 聚合物(示例见图2) 半导体:Si、aSi、多晶硅 硬质涂层:SiC、DLC 聚合物涂层:对二甲苯、PMMA、聚酰胺 薄金属涂层(厚度<50 nm。示例见图3)
|
光谱范围 | 450 nm - 1050 nm |
| 精确 | 0.01 nm or 0.02% |
| 准确 | 0.2% or 1 nm |
| 稳定 | 0.02 nm or 0.03% |
光斑 | 1 mm minimum |
最小数据采集时间 | 10 us |
样本量要求 | Minimum 5 mm x 5 mm for reliable measurement |
光谱仪/探测器 | 2048/4096像素CMOS 16位ADC 400-1100nm波长范围 光谱分辨率:<1 nm 电源100-240VAC,50/60Hz,20W电源 |
光源 | 5W卤钨灯 CT 2800度 寿命:10000小时 |
反射探头 | 光纤,400微米纤芯 带光谱仪腿和照明腿 |
面朝上测量 | 胶片样品面朝上,探头和光源指向下
|
通信接口和笔记本电脑 | USB接口,用于与PC通信 包括一台安装了软件的全新笔记本电脑,可立即使用 |
软件:TFCompanion | 1.最常见的金属、电介质、非晶和晶体基板材料的折射率(n)和消光系数(k)值的大型库 2.能够分析简单和最复杂的薄膜堆叠 3.误差估计和模拟工具允许考虑变化条件的影响 4.支持参数化材料,其近似值表示所需光谱范围内的光色散,使用很少的可调整系数。
|
软件选项 | 基于Modbus协议的远程控制(TCP)需要额外付费 |
计量标准(含) | 裸硅参考和200 nm厚的氧化硅测试晶片被用作厚度测量验证的薄膜标准 |
| 尺寸 | 205 mm L x 250 mm W x 105 mm H (8" L x10" W x4" H) |
重量 | 4.5 kg (10 lbs) |
| 保修 | 一年有限保修,终身支持。(薄膜测量标准等易损件不在保修范围内) |


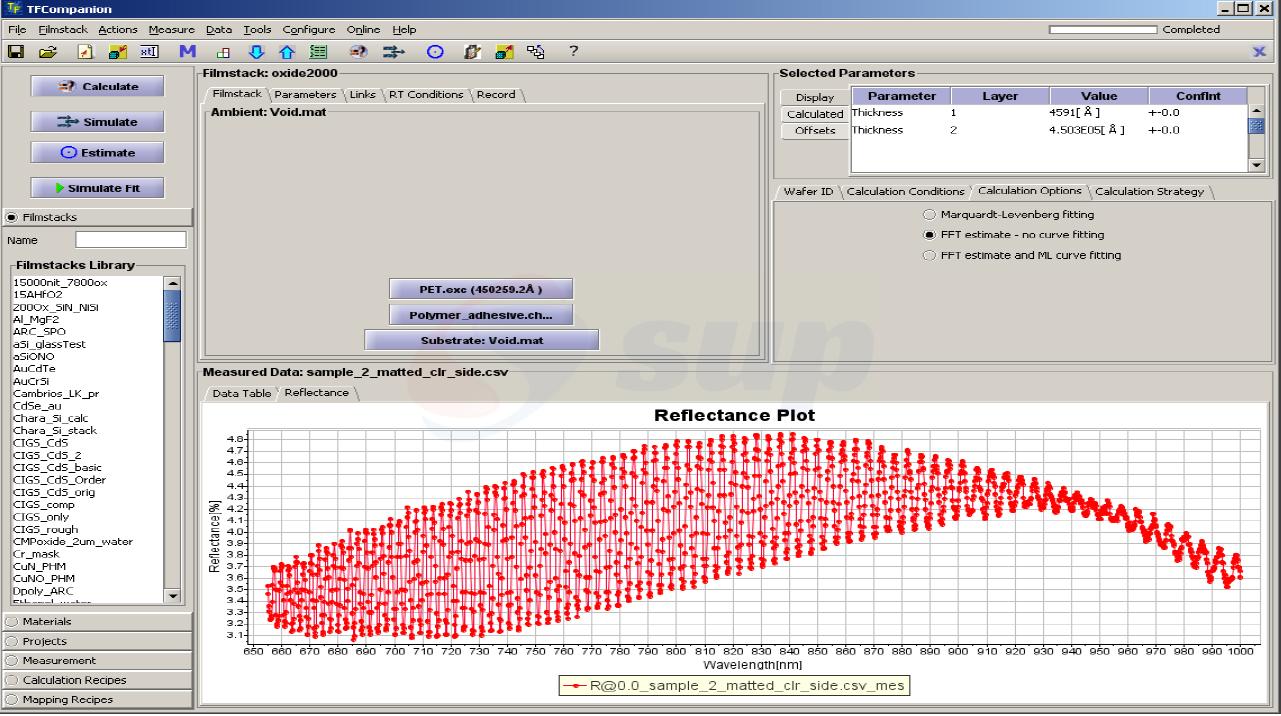
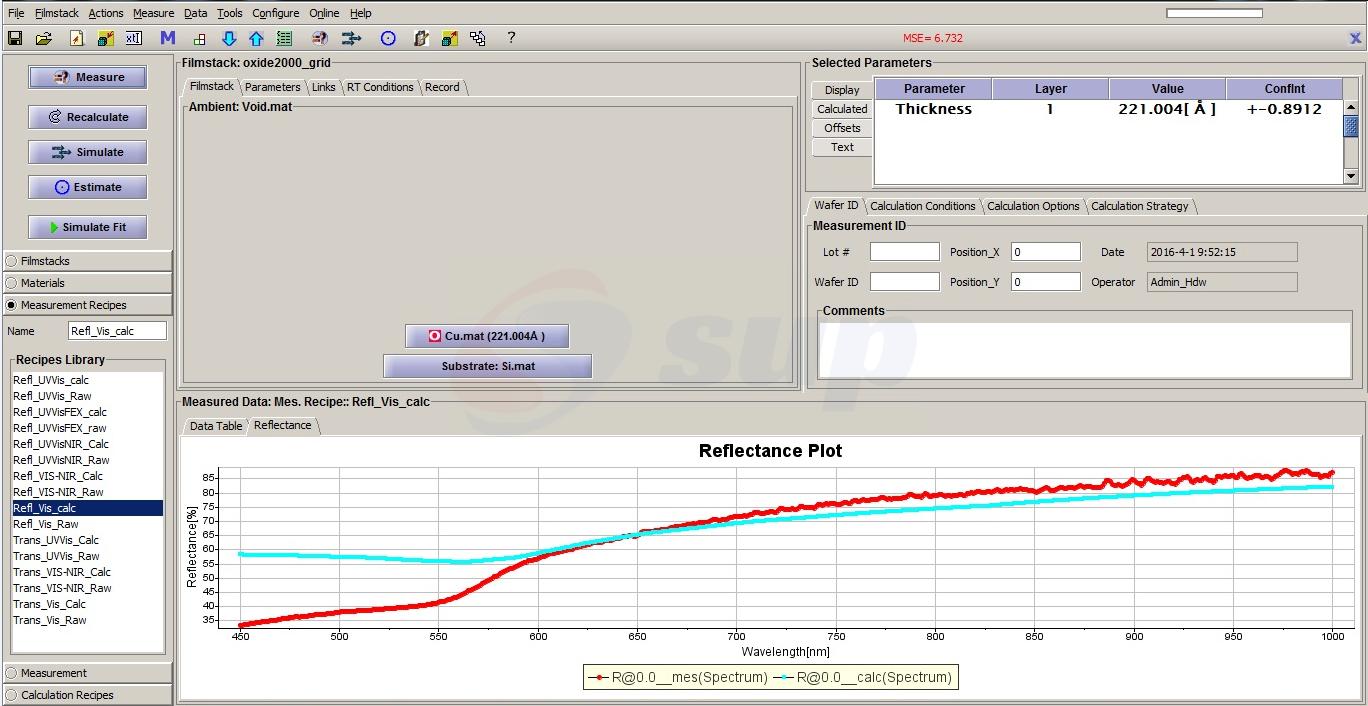
联系人:Bruce Liu
手机:+86-18059149998
电话:+86-18059149998
邮箱:sales@supsemi.com
地址: 福建省龙岩市新罗区西陂街道西山村西陂路89号1幢1402室
二维码
